本文綜述了近年來新型、高端基板材料使用的特種電解銅箔、特種樹脂和特種玻璃纖維布的供應鍊格局,以及這三種材料的新性能要求。
2020年以來,全球新冠疫情蔓延,導致中國覆銅材料供需鍊格局發生嚴重變化。5G發展以來,技術、性能、品種等都發生了巨大變化。高頻高速電路用基板材料、高HDI及IC封裝載板。面對這兩大變化,探討新型高端基板材料用電子銅箔的供應鍊格局。
低斷面電解銅箔在不同應用領域的性能差異化
高頻和高速電路中使用的薄型電解銅箔的種類和種類,按其應用領域分為五類:剛性射頻/微波電路用薄型電解銅箔;高速數字電路用薄型電解銅箔電路板;柔性PCB薄型電解銅箔;密封加載板用薄型電解銅箔;厚銅PCB薄型電解銅箔.這五個應用領域在高頻高速電路中使用的薄型電解銅箔的性能要求方面具有不同的特點,即對性能項目有一定的重視,在性能指標上存在差異。
用於五個主要應用領域的薄型電解銅箔的性能要求和差異表現在以下幾個方面:
(1) 剛性射頻/微波電路用薄型電解銅箔
用於剛性射頻/微波電路的薄型電解銅箔在不同的應用頻率下表現出更明顯的相對差異。 無源互調等因素,要求比較嚴格。
為此,用於高檔射頻-微波電子基板的銅箔(如用於毫米波車載雷達的基板)一般需要採用純銅處理工藝進行表面處理,以支持減少無源互調(PIM) 並實現覆銅板的低 PIM 特性。參考指標在-158DBC~-160DBC以下。銅箔處理層無砷。
同時,由於該類銅箔的樹脂基材不同,不同RZ銅箔品種的選擇也存在較大差異。
剛性射頻/微波電路用低剖面電解銅箔在銅箔規格方格厚度,一般用途:18μm、35μm、70μm,以及高端極低或超低剖面銅箔,厚度規格多用途:9μm、12μm、18μm品種。
(2)高速數字電路用薄型電解銅箔
高速數字電路的薄型銅箔應用大多位於厘米波頻率範圍(3~30GHz)。其主要應用終端是高中端服務器。這種銅箔的性能有對基板的插入損耗和基板的可加工性有更重要的影響,因此對此有嚴格的要求。同時,銅箔的薄形規格和低成本也是重要要求。高速數字線路用薄型電解銅箔在銅箔的厚度規格方面,一般採用:18μm、35μm、70μm,以及高端極低或超薄型銅箔,厚度規格多用途:9μm、12μm、18μm品種.
筆者對各種銅箔低Rz(HVLP、VLP、RTF等品種)的壓制型材進行了多品種的調查、比較、指導,得出的結論是:在同類品種品牌中,無論是SI性關係較好的品種,其非壓製表面輪廓(Rz或Ra)普遍較低。例如,國外企業的RTF銅箔產品,其RZ=3.0μm(典型值),非壓製表面輪廓(Rz或Ra)普遍較低。表面RZ = 3.5μm。因此,無論是RF/微波路堤板還是高速數字路堤板,為了追求更好的Si性能,還需要非壓面RZ(或Ra,RQ)使用輪廓形狀的銅箔,其輪廓也非常低。
高速數字電路中使用的最重要的低剖面銅箔類別之一是反向銅箔(RTF)。 近年來,日本、台灣等銅箔企業在RTF銅箔技術上取得進展,其RZ小於2.5μm的多個品種已經問世,甚至出現了RZ小於2.0μm的品種。因此,其應用市場,以及全球低剖面銅箔使用的市場規模比例高速數字電路,得到了迅速擴展。
目前,全球銅箔薄型電解銅箔製造行業在剛性射頻/微波電路中使用的銅箔種類和高速數字電路中使用的銅箔種類趨於相同。例如,CircuitFoil 2019年來自盧森堡的超低輪廓銅箔BF-NN/BF-NN-HT實現量產,該品種實現了“兩兼容”:一是從原來的BF-ANP銅箔只用在PTFE樹脂類基材上,發展到“包括聚苯醚(PPE/PPO)樹脂體系。也適用於純或改性含氟聚合物(PTFE)樹脂體系。”其次,可應用於射頻和微波高頻板,也適用於高速數字電路的高速板。
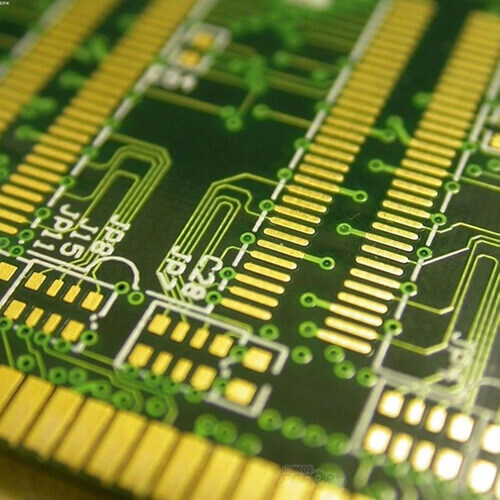
電路板
(3) 薄型電解銅箔柔性PCB
柔性線電路板採用薄型電解銅箔,由於製造細線的需要,大多采用極薄的銅箔(無載體)。目前該品種最小厚度規格已達到6μm,如富達金屬箔Powder Co., CF-T4X-SV6, CF-T49A-DS-HD2;和三井金屬的3EC-MLS-VLP(厚度最小7μm)。
低斷面電解銅箔柔性PCB還要求銅箔具有高抗拉強度、高延伸率。蝕刻基膜優異的透明性也是銅箔市場的重要需求項目。
近年來,高頻柔性PCB中使用的薄型電解銅箔開始向薄型化發展,現在業界RZ小於1.0um的品種很多。例如三井金屬TQ-M4-VSP RZ≤ 0.6(典型值);Foton Metal CF-T4X-SV Rz=1.0(Typical,9/12/18);Foton Metal CF-T49A-DS-HD2,Rz= 1.0μm(典型值)(6/9/12/ 18);漸進式 ISP,RZ ≤0.55(典型)。
(4) 低斷面電解銅箔IC密封加載板
封接加載板(包括模塊基板)所需的低斷面電解銅箔應具有高拉伸強度、高熱穩定性、高彈性模量和高溫(210℃/1h處理後)剝離強度。 其厚度規格為5.0μm~12μm。而近年來,高端IC封裝載板用銅箔的厚度規格正朝著更極薄的方向發展,即厚度達到1.5μm~3μm。
近年來,封裝裝載板(包括模塊基板)的高頻、高速化要求也出現了。因此,近年來出現了更多類型的封接板用低斷面電解銅箔。例如三井Metal's 3EC-M2S-VLP(無載體),Rz≤1.8μm(典型值);210℃/1h時抗拉強度51kgf/mm 2;延伸率4.6%;銅箔最薄9μm。三井金屬MT18FL(帶載體),RZ≤1.3μm,成型電路銅箔規格1.5、2、3μm.LPF(無載體)RZ≤1.72(典型值),210℃/1h拉伸強度52.3 KGF /mm 2 ;伸長率3.7%;銅箔最薄尺寸為9μm。
(5)大電流厚銅PCB用薄型電解銅箔
對於厚度規格≥105um(3oz)的大電流厚銅PCB,採用low profile電解銅箔。常用規格有105、140、175、210μm。超厚電解銅箔有特殊厚度要求,厚度規格可達350μm(10oz)、400μm(11.5oz)。
大電流厚銅PCB帶低剖面電解銅箔,主要用於大電流、電源基板、高散熱電路板製造。製造的厚銅PCB主要用於汽車電子、電源、大功率工控設備、太陽能設備等。近年來,PCB的導熱性能成為最受歡迎和重要的功能之一。超厚銅箔的市場正在擴大。同時,由於製造業的發展厚銅PCB細線技術及應用,需要採用的超厚銅箔也具有薄型特性。 三井金屬RTF型薄型,例如厚銅箔:MLS-G(Ⅱ型),Rz = 2.5 微米(典型)產品。盧森堡 TW-B,RZ ≤ 4。2μm(產品指標)
IC封口載板用超薄電解銅箔的市場拓展及性能需求
在近期海外PCB專家撰寫的一篇論文中,描述了超薄、低剖面銅箔的應用市場和性能要求。 論文提出:“自2017年以來,HDI板開始大量採用IC板產品被廣泛應用於線路電鍍工藝。該工藝稱為半加成工藝(SAP),是採用線路電鍍技術,滿足IC板小於15μm線路結構要求,此工藝已成為HDI的主流之後的製造工藝並未採用一般HDI板PCB生產製程,而是採用超薄銅板半加成技術(MSAP)調整。”
“IC用的半加成法(SAP)與SLP用的帶銅箔的半加成法(MSAP)的區別在於加工的板材是否為預壓超薄銅箔。目前成熟的SAP工藝通常是ABF薄膜材料,採用全板沉澱銅工藝,不適用於現有的大多數生產設備。這導致了改進的解決方案,超薄銅箔的半加成工藝。”
本文給出了半加成工藝(MSAP)與超薄銅箔(見圖2)的對比。這裡標註了“預壓超薄銅箔”的位置,讓讀者有一個清晰的認識。
銅箔半加成工藝的關鍵是載體銅的使用,這有助於穩定銅箔的剝離強度,加強對纖維的支撐,”論文建議。 -薄銅箔,採用壓制法塗覆在基材上,主要包括:高且穩定的銅箔剝離強度,超薄銅箔的厚度均勻性,低表面粗糙度,合適的抗銅箔光滑表面的氧化塗層,精細電路的蝕刻等。其中,銅箔剝離強度是最重要的性能項目。