HDI PCB制程是以傳統雙面板為芯板,通過不斷積層層壓而成。 這種由不斷積層的制程的電路板也被稱作積層多層板(Build-up Multilayer,BUM)。 相對於傳統的電路板,HDI PCB具有“輕、薄、短、小”等優點。
HDI PCB的層間電氣互連是通過導電的通孔、埋孔和盲孔連接實現的,其結構上不同於普通的多層電路板制程,HDI PCB電路板制程中大量採用微埋盲孔和雷射直接鑽孔,而標準PCB制程通常採用機械鑽孔,囙此層數和高寬比往往會比傳統標準PCB降低。相比於普通PCB,HDI PCB最顯著的特點是電路密度更高、體積更小、重量更輕。
愛彼電路提供高精密HDI電路板模範及批量的製造,支持HDI PCB的模範快銑。 以下是愛彼電路的制程能力錶,歡迎您與我們聯絡。
HDI PCB定義
1、HDI孔:指由雷射鑽機製作完成的導通孔,亦稱H孔或盲孔或雷射孔。
2、三階HDI PCB:指至少含有L1/2/3/4或L1/4三階HDI孔的PCB(板上同時可能還有一/二階HDI孔,也可能沒有一/二階HDI孔),通常該板結構表達為:3+X+3,多階板依此類推。
3、多階板HDI PCB:指三階或三階以上的HDI PCB,通常該板結構表達為:n+X+n,(n≥3)。
4、Anylayer 任意互聯HDI電路板:指相鄰每層都僅含一階HDI孔的PCB板。 通常該板結構表達為:n+2+n,其由雙面板開始,依此疊加進行壓板及鑽鐳射孔。
5、三階及Anylayer HDI PCB結構中各種HDI層別定義表示如下:
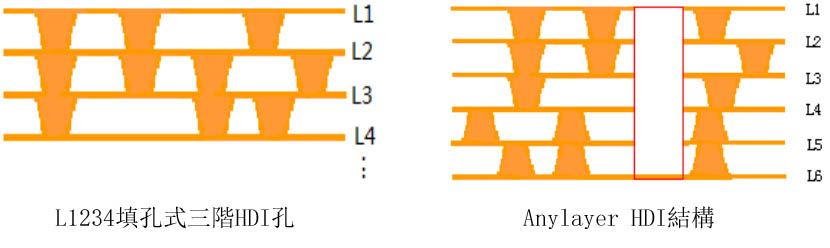
HDI 結構
三階盲孔設計的生產制程L04/05,L06/07
開料 → IDF(前處理 → 貼膜 → 曝光 → DES) → IAOI
階梯式三階盲孔設計的生產制程L03/08
L04/05,L06/07棕化 → L03/08排板/層壓 → CFM鑽靶/壓板後處理 → 减銅 → 二次棕化 → LDD雷射鑽孔 → 機械鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 全板電鍍 → L03/08 IDF(前處理 → 貼膜 → 曝光 → DES) → L03/08OAOI
填孔式三階盲孔設計的生產制程(L03/08)
L04/05,L06/07棕化 → L03/08排板/層壓 → CFM鑽靶/壓板後處理 → 减銅(1) → 二次棕化 → LDD雷射鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 水准填孔電鍍 → X-RAY鑽靶孔 → 减銅(2) → 機械鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 全板電鍍 → L03/08 IDF(前處理 → 貼膜 → 曝光 → DES) → L03/08OAOI
階梯式三階盲孔設計的生產制程L02/09
L02/09棕化 → L02/09排板/層壓 → CFM鑽靶/壓板後處理 → 二次棕化 → LDD雷射鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 全板電鍍 → L02/09IDF(前處理 → 貼膜 → 曝光 → DES) → L02/09內層AOI
階梯式三階盲孔設計的生產制程L01/10
L01/10棕化 → L01/10排板/層壓 → CFM鑽靶/壓板後處理 → 减銅 → 二次棕化 → LDD雷射鑽孔 → 機械鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 全板電鍍 → L01/10 ODF(前處理 → 貼膜 → 曝光 → DES) → L01/10OAOI
填孔式三階盲孔設計的生產制程L02/09
L02/09棕化 → L02/09排板/層壓 → CFM鑽靶/壓板後處理 → 二次棕化 → LDD雷射鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 水准填孔電鍍 → L02/09 IDF(前處理 → 貼膜 → 曝光 → DES) → L02/09內層AOI
填孔式三階盲孔設計的生產制程(L01/10)
L01/10棕化 → L01/10排板/層壓 → CFM鑽靶/壓板後處理 → 减銅(1) → 二次棕化 → LDD雷射鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 水准填孔電鍍 → X-RAY鑽靶孔 → 减銅(2) → 機械鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 全板電鍍 → L01/10 ODF(前處理 → 貼膜 → 曝光 → DES) → L01/10 OAOI
Anylayer的生產制程(以10層Anylayer為例)
{L5/6開料-- L5/6機械鑽孔(鑽工具孔) → 鑼板修邊(倒圓角) → L5/6IDF(採用濕膜做CFM開窗)或者二次棕化 → L5/6雷射鑽孔-- L5/6除膠 → L5/6沉銅閃鍍 → L5/6水准填孔電鍍 → L5/6IDF(前處理-貼膜-曝光-DES)-- L5/6AOI} → {L4/7棕化 → 排板壓板 → CFM鑽靶孔--壓板後處理 → 二次棕化 → 雷射鑽孔(LDD) → 磨板--除膠 → 沉銅閃鍍 → 水准填孔 → IDF(前處理-貼膜-曝光-DES) → IAOI} → {L3/8棕化 → 排板壓板 → CFM鑽靶孔--壓板後處理 → 二次棕化 → 雷射鑽孔(LDD) → 磨板--除膠 → 沉銅閃鍍 → 水准填孔 → IDF(前處理-貼膜-曝光-DES) → IAOI}-- {L2/9棕化 → 排板壓板 → CFM鑽靶孔--壓板後處理 → 二次棕化 → 雷射鑽孔(LDD) → 磨板--除膠 → 沉銅閃鍍 → 水准填孔 → IDF(前處理-貼膜-曝光-DES) → IAOI} → L1/10棕化 → 排板壓板 → CFM鑽靶孔 → 壓板後處理 → 减銅--二次棕化 → 通盲孔折開電鍍(雷射鑽孔(LDD) → 磨板 → 除膠 → 沉銅閃鍍 → 水准填孔電鍍 → XRAY鑽靶孔 → 减銅(2) → 機械鑽孔 → 磨板--除膠 → 沉銅閃鍍 → 全板電鍍)/通盲孔合鍍(雷射鑽孔(LDD) → 機械鑽孔 → 磨板 → 除膠 → 沉銅閃鍍 → 垂直填孔電鍍 → 水准填孔電鍍) → 機械鑽孔 → ODF(前處理-貼膜-曝光-DES) → OAOI}
後工序走典型生產流程,外層板表面塗覆與檢測生產制程
綠油 → 字元 → 沉鎳金 → 阻抗測試 → 銑外形 → ETEST → 最終檢驗 → FQA抽檢 → 包裝
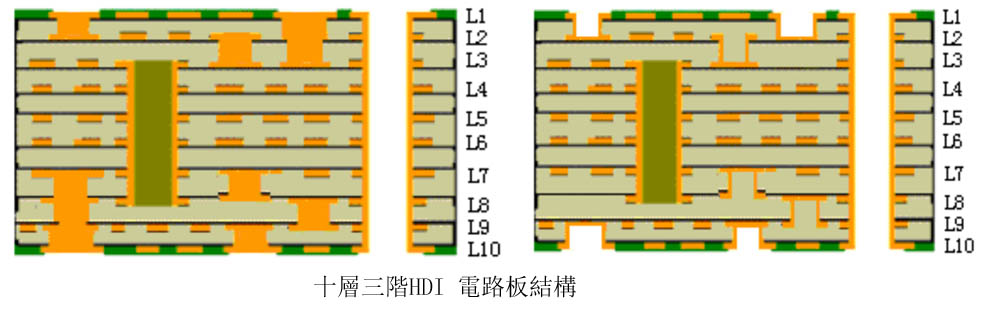
現階段,愛彼電路的HDI PCB制程能力科技已突破最高層數為38層,盲孔階數1階到7階或者anylayer任意互聯HDI,最小孔徑0.05mm。