BGA(Ball Grid Array)封裝,即球栅陣列封裝,它是在封裝體基板的底部製作陣列焊球作為電路的I/O端與印刷線路板(PCB)互接。 採用該項科技封裝的器件是一種表面貼裝型器件。
BGA封裝分類
1、PBGA(Plastic BGA)基板:一般為2-4層有機材料構成的多層板。 Intel系列CPU中,Pentium II、III、IV處理器均採用這種封裝形式。 近二年又出現了另一種形式:即把IC直接綁定在板子上,它的價格要比正規的價格便宜很多,一般用於對質量要求不嚴格的遊戲等領域。
2、CBGA(CeramicBGA)基板:即陶瓷基板,晶片與基板間的電力連接通常採用倒裝晶片(FlipChip,簡稱FC)的安裝方式。 Intel系列CPU中,Pentium I、II、Pentium Pro處理器均採用過這種封裝形式。
3、FCBGA(FilpChipBGA)基板:硬質多層基板。
4、TBGA(TapeBGA)基板:基板為帶狀軟質的1-2層PCB電路板。
5、CDPBGA(Carity Down PBGA)基板:指封裝中央有方型低陷的晶片區(又稱空腔區)
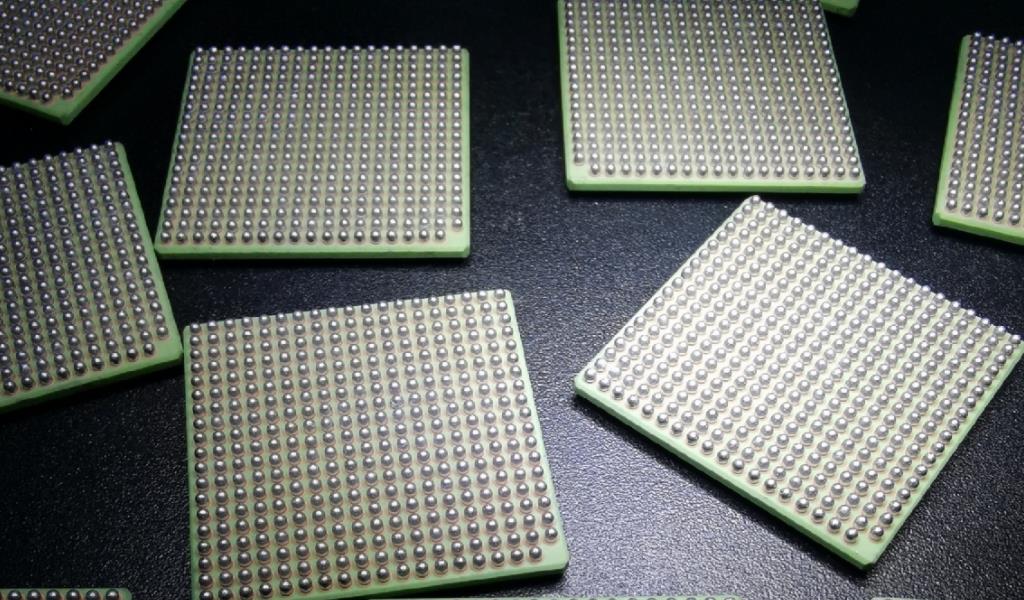
BGA封裝
現時IC的封裝樣式有很多,並且各有千秋,比如比較主流的封裝管道有BGA封裝、SOP封裝、QFN封裝、PLCC封裝、SSOP封裝、QFP封裝等。 那麼今天我們分享一下BGA封裝優點與BGA封裝缺點。
BGA封裝的優點
1、BGA體積小記憶體容量大,同樣記憶體IC在相同容的量下,BGA體積只有SOP封裝的三分之一。
2、QFP、SOP的封裝引脚分佈在本體四周,當引脚多,間距縮小到一定程度,引脚易變形彎曲,但是BGA焊球在封裝底部,間距反而增大,大大提高了成品率。
3、電器效能好,BGA引脚很短,用錫球代替了引線,訊號路徑短。 减小了引線電感和電容,增强了電器效能。
4、散熱性好,球形觸點陣列與基板接觸面形成間隙,有利於本體散熱。
5、BGA本體與PCB板有良好的共面性,能有效保證焊接質量。
BGA封裝的缺點
1、BGA焊接後質量檢查和維修比較困難,必須使用X-Ray透視檢測,才能確保焊接連接的電器效能。 無法通過肉眼與AOI來判定檢測質量。
2、BGA引脚在本體的底部,易引起焊接陰影效應,囙此對焊接溫度曲線要求較高。 必須要即時監測焊接實際溫度。
3、BGA引脚個別焊點焊接不良,必須把整個BGA取下來重新植球,再進行第二次貼片焊接。 影響直通率及電器效能。
4、BGA封裝很牢靠,同20mil間距的QFP相比,BGA沒有可以彎曲和折斷的引脚。 焊接牢靠,一般如果要拆除BGA封裝的話必須使用BGA返修臺高溫進行拆除才能够完成。

BGA封裝基板
BGA的封裝類型多種多樣,其外形結構為方形或矩形。 根據其焊料球的排布管道可分為周邊型、交錯型和全陣列型BGA,根據其基板的不同,主要分為三類:PBGA(PlasticballZddarray塑膠焊球陣列)、CBGA(ceramicballSddarray陶瓷焊球陣列)、TBGA(tape ball grid array載帶型焊球陣列)。
PBGA(塑膠焊球陣列)封裝
PBGA封裝,它採用BT樹脂/玻璃層壓板作為基板,以塑膠(環氧模塑混合物)作為密封材料,焊球為共晶焊料63Sn37Pb或准共晶焊料62Sn36Pb2Ag(已有部分製造商使用無鉛焊料),焊球和封裝體的連接不需要另外使用焊料。 有一些PBGA封裝為腔體結構,分為腔體朝上和腔體朝下兩種。 這種帶腔體的PBGA是為了增强其散熱效能,稱之為熱增强型BGA,簡稱EBGA,有的也稱之為CPBGA(腔體塑膠焊球陣列)。
PBGA封裝的優點如下:
1、與PCB板(印刷線路板-通常為FR-4板)的熱匹配性好。 PBGA結構中的BT樹脂/玻璃層壓板的熱膨脹係數(CTE)約為14ppm/℃,PCB板的約為17ppm/cC,兩種材料的CTE比較接近,因而熱匹配性好。
2、在回流焊過程中可利用焊球的自對準作用,即熔融焊球的表面張力來達到焊球與焊盤的對準要求。
3、成本低。
4、電性能良好。
PBGA封裝的缺點是:對濕氣敏感,不適用於有氣密性要求和可靠性要求高的器件的封裝。
CBGA(陶瓷焊球陣列)封裝
在BGA封裝系列中,CBGA的歷史最長。 它的基板是多層陶瓷,金屬蓋板用密封焊料焊接在基板上,用以保護晶片、引線及焊盤。 焊球材料為高溫共晶焊料10Sn90Pb,焊球和封裝體的連接需使用低溫共晶焊料63Sn37Pb。 標準的焊球節距為1.5mm、1.27mm、1.0mm。
CBGA(陶瓷焊球陣列)封裝的優點如下:
1、氣密性好,抗濕氣效能高,因而封裝組件的長期可靠性高。
2、與PBGA器件相比,電絕緣特性更好。
3、與PBGA器件相比,封裝密度更高。
4、散熱效能優於PBGA結構。
CBGA封裝的缺點是:
1、由於陶瓷基板和PCB板的熱膨脹係數(CTE)相差較大(A1203陶瓷基板的CTE約為7ppm/cC,PCB板的CTE約為17ppm/筆),囙此熱匹配性差,焊點疲勞是其主要的失效形式。
2、與PBGA器件相比,封裝成本高。
3、在封裝體邊緣的焊球對準難度增加。
CCGA(ceramiccolumnSddarray)陶瓷柱栅陣列
CCGA是CBGA的改進型。 二者的區別在於:CCGA採用直徑為0.5mm、高度為1.25mm~2.2mm的焊料柱替代CBGA中的0.87mm直徑的焊料球,以提高其焊點的抗疲勞能力。 囙此柱狀結構更能緩解由熱失配引起的陶瓷載體和PCB板之間的剪切應力。
TBGA(載帶型焊球陣列)
TBGA是一種有腔體結構,TBGA封裝的晶片與基板互連管道有兩種:倒裝焊鍵合和引線鍵合。 倒裝焊鍵合結構; 晶片倒裝鍵合在多層佈線柔性載帶上; 用作電路I/O端的周邊陣列焊料球安裝在柔性載帶下麵; 它的厚密封蓋板又是散熱器(熱沉),同時還起到加固封裝體的作用,使柔性基片下麵的焊料球具有較好的共面性。
TBGA的優點如下:
1、封裝體的柔性載帶和PCB板的熱匹配效能較
2、在回流焊過程中可利用焊球的自對準作用,
印焊球的表面張力來達到焊球與焊盤的對準要求。
3、是最經濟的BGA封裝。
4、散熱效能優於PBGA結構。
TBGA的缺點如下:
1、對濕氣敏感。
2、不同材料的多級組合對可靠性產生不利的影響。
有BGA封裝的PCB基板