晶片封裝科技有很多種,如COB,QFN,BGA,PLCC等等,至於採用哪種封裝管道,取決於晶片的結構.
SMT貼片加工而言,BGA焊接與LGA焊接可算作一項難度比較大的工藝,就這些年來從事XRAY檢測設備生產過程中,經常會遇到需要用XRAY檢測BGA焊接、SMT貼片等工藝後產品的合格率。
BGA封裝與LGA封裝有什麼區別呢?
BGA全稱BALL GRID ARRAY,意思是球栅網格陣列封裝.
BGA封裝是使用球形焊點連接晶片和主機板,這些球形焊點位於晶片的底部。 在安裝BGA封裝的晶片時,通常需要使用熱風槍或冷卻液對晶片進行加熱或冷卻,以便將底部的球形焊點與主機板上的焊盤粘合在一起。
BGA封裝能提供比其他如雙列直插封裝(Dual in-line package)或四側引脚扁平封裝(Quad Flat Package)所容納更多的接脚,整個裝置的底部表面可全作為接脚使用,而不是只有周圍可使用,比起周圍限定的封裝類型還能具有更短的平均導線長度,以具備更佳的高速效能。
BGA的封裝根據焊料球的排布管道可分為交錯型、全陣列型、和周邊型。 按封裝形式可分為TBGA、CBGA、FCBGA、和PBGA。
BGA封裝的特點
1、成品率高。 採用BGA可將細間距QFP的焊點的失效率200x10-6再减小到兩個數量級,且無需對工藝作大的改動。
2、設備簡單。 BGA焊點的中心距一般為1.27mm,可以利用現有SMT工藝設備。 而QFP的引脚中心距如果小到0.3mm時,引脚間距只有0.15mm,則需要很精密的安放設備以及完全不同的焊接工藝,並且實現起來極為困難。
3、引脚數量大。 改進了器件引出數和本體尺寸的比率。 例如,邊長為31mm的BGA,當間距為1.5mm時有400只引脚; 而當間距為1mm時有900只引脚。 相比之下,邊長為32mm,引脚間距為0.5mm的QFP只有208只引脚。
4、共面損壞小。 明顯改善共面問題,减少了共面損壞。
5、引脚牢固。 BGA引脚牢固,不像QFP那樣存在引脚變形問題。
6、電效能好。 BGA引脚很短,使訊號路徑短,减小了引線電感和電容,增强了電效能。
7、散熱性好。 球形觸點陣列有利於散熱。
8、封裝密度高。 BGA適合MCM的封裝需要,有利於實現MCM的高密度、高性能。

BGA封裝
LGA全稱LAND GRID ARRAY,意思平面網格陣列封裝. LGA封裝基本上是與BGA封裝反過來的,它將焊點放在了主機板的底部。 LGA封裝的晶片有許多小型接線柱,它們可以方便地插入主機板中的孔中。 創建電路連接後,在晶片的頂部添加散熱器。
LGA能够以比較小的封裝容納更多的輸入輸出引脚。 另外,由於引線的阻抗小,對於高速LSI是很適用的。 但由於插座洪阿製作複雜,成本高,現在基本上不怎麼使用。 預計今後對其需求會有所增加。
隨著科技的發展,LGA已經被很多廠商所使用,INTEL陸續推出LGA775,LGA1155的新酷睿等系列CPU。 LGA封裝不需要植球,適合輕薄短小的產品應用。
INTEL推出的移動處理器I5/I7型號,重新採用BGA。 這意味這些處理器不能像LGA封裝的處理器那樣可以替換,而永遠不能從筆記本主機板上拆卸下來。
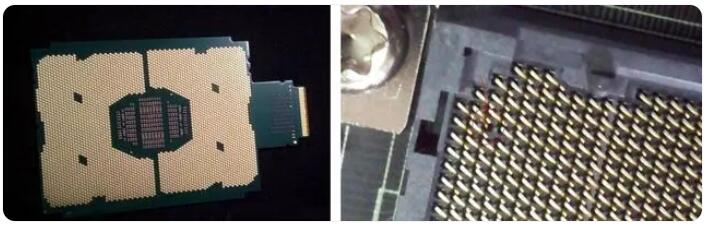
LGA封裝
BGA封裝與LGA封裝兩者在各個角度看都存在很大的不同
1、BGA封裝體積相對較小,無引脚焊接。
2、BGA封裝採用無引脚焊接,外面看不到引脚的,屬於一次性封裝管道,一旦焊接如果需要拆卸需要使用專業的工具,而LGA封裝焊接的引脚都焊接在主機板上,外面是可以看到的,也可以單獨更換。
3、BGA封裝相對LGA封裝比較小型化,導熱效能相對弱。
4、尺寸大所對應的功耗也較大,BGA封裝相對LGA封裝的尺寸要小,所以功耗也較小。 這也是為什麼BGA晶片越來越小的原因,越小所承載的功耗小,各個方面都具有更强的競爭力,比如待機時間長,性價比更高等。