IC載板就是用以封裝IC裸晶片的基板
IC載板作用
1、承載電晶體IC晶片。
2、內部布有線路用以導通晶片與電路板之間連接。
3、保護、固定、支撐IC晶片,提供散熱通道,是溝通晶片與PCB的中間產品。
IC載板誕生
20世紀90年代中期,其歷史不到20年。 BGA球栅陣列封裝、、CSP晶片尺寸封裝、為代表的新型集成電路IC、高密度封裝形式問世,從而產生了一種封裝的必要新載體——IC封裝基板。
電晶體的發展歷程:電子管→電晶體→通孔揷裝→表面封裝SMT、→晶片級封裝CSP,BGA、→系統封裝(SIP)
印刷電路板與電晶體科技相互依存、靠攏、滲透,緊密配合,印刷電路板才能實現各種晶片、元器件之間的電絕緣和電力連接,提供所要求的電力特性。
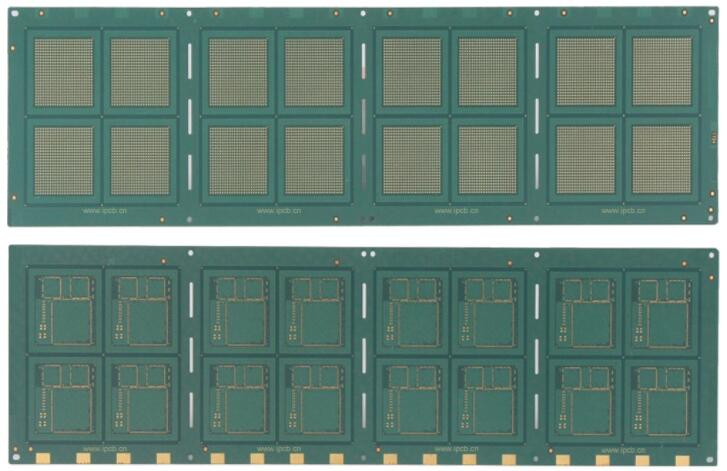
IC載板技術參數
層數:2~10多層
板厚:通常0.1~1.5mm
最小板厚公差:0.05微米
最小孔徑:通孔0.1mm,微孔0.03mm
最小線寬/間距:10~80微米
最小環寬:50微米
外形公差:0~50微米
需要的科技:埋盲孔,阻抗,埋阻容
表面塗覆:Ni/Au,軟金,硬金,鎳/鈀/金等
板子尺寸:單一IC載板≤240*90mm
IC載板要求更精細、高密度、高脚數、小體積,孔、盤、線更小,超薄芯層。 因而必須具有精密的層間對位科技、線路成像科技、電鍍科技、鑽孔科技、表面處理科技。 對產品可靠性,對設備和儀器,資料和生產管理全方位地提出了更高的要求。 囙此,IC載板的科技門檻高,研發不易。
IC載板科技難點與傳統的PCB製造比較,IC載板要克服的科技難點:
1、芯板製作科技芯板薄,易變形,尤其是板厚≤0.2mm時,配板結構、板件漲縮、層壓參數、層間定位系統等工藝科技需取得突破,從而實現超薄芯板翹曲和壓合厚度的有效控制。
2、微孔科技
包括:開等窗工藝,雷射鑽微盲孔工藝,盲孔鍍銅填孔工藝。
開等窗工藝Conformalmask、是對雷射盲孔開窗進行合理補償,通過開出的銅窗直接定義出盲孔孔徑和位置。
雷射鑽微孔涉及的名額:孔的形狀、上下孔徑比、側蝕、玻纖突出、孔底殘膠等。
盲孔鍍銅涉及的名額有:填孔能力、盲孔空洞、凹陷、鍍銅可靠性等。
現時微孔孔徑是50~100微米,疊孔層數達到3階、4階、5階。
3、圖形形成和鍍銅科技
線路補償科技和控制; 精細線路製作科技; 鍍銅厚度均勻性控制科技; 精細線路的微蝕量控制科技。
現時線寬間距要求是20~50微米。 鍍銅厚度均勻性要求為18微米,蝕刻均勻性≥90%。
4、阻焊工藝包括塞孔工藝,阻焊印製科技等。
IC載板阻焊表面高度差小於10微米,阻焊和焊盤的表面高度差不超過15微米。
5、表面處理科技
鍍鎳/金的厚度的均勻性; 在同一板上既鍍軟金,也鍍硬金工藝; 鍍鎳/鈀/金工藝科技。
可打線的表面塗覆,選擇性表面處理科技。
6、檢測能力和產品可靠性測試技術
需要配備一批與傳統PCB廠不同的檢測設備/儀器。
掌握與常規不同的可靠性檢測科技。
7、綜合起來,生產IC載板涉及的工藝科技有十餘個方面:
圖形動態補償
鍍銅厚度均勻性的圖形電鍍工藝
全流程資料漲縮控制
表面處理工藝,軟金加硬金選擇性電鍍,鍍鎳/鈀/金工藝科技
芯板薄片製作
高可靠性檢測科技微孔加工
若疊微3階、4階、5階,生產流程
多次疊層層壓層壓≥4次鑽孔≥5次電鍍≥5次。
導線圖形形成和蝕刻
高精度對位系統
阻焊塞孔工藝,電鍍填微孔工藝
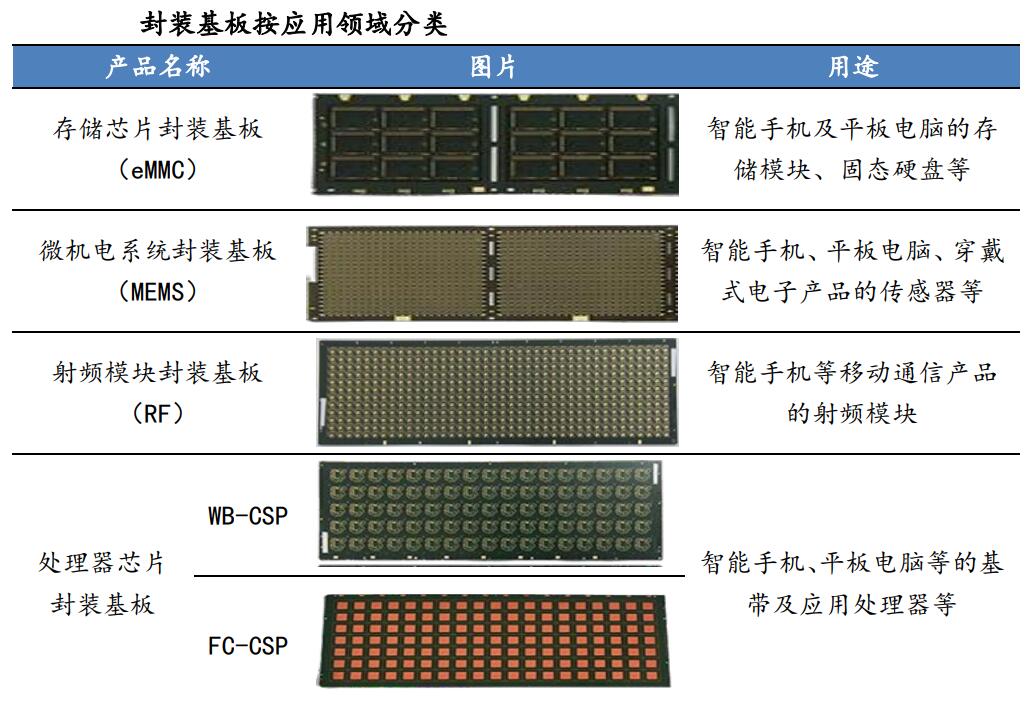
IC載板分類
以封裝形式區分
1、BGA載板
BallGridAiry,其英文縮寫BGA,球形陣列封裝。
這類封裝的板子散熱性、電效能好,晶片管脚可大量新增,應用於300管脚數pincount、以上的IC封裝。
2、CSP載板
CSP即chipscalepackaging的英文縮寫,晶片級尺寸封裝。
屬單一晶片的封裝,輕量、小型,其封裝尺寸和IC本身尺寸幾乎相同或稍大,應用於記憶性產品、通信產品、管脚數不高的電子產品。
3、覆晶載板
其英文是FlipChipFC、,將晶片正面翻覆Flip、,以凸塊直接連接載板的封裝形式。
這類載板具有低訊號干擾,連接電路損耗低,電效能佳,有效率的散熱途徑等優點。
4、多晶片模組
英文是Multi-ChipMCM、,中文叫作多芯晶、片模組。 將多種不同功能的晶片置於同一封裝體內。
這是為電子產品走向輕、薄、短、小於高速無線化的最佳解決方案。 用於高階大型電腦或特種效能電子產品上。
因有多個晶片在同一封裝體內,訊號干擾、散熱、細線路設計等現時還沒有較完整的解決方案,屬於積極發展的產品。
以IC載板材質分類
1、硬板封裝載板
以環氧樹脂、BT樹脂、ABF樹脂作成的剛性有機封裝基板。 其產值為IC封裝基板的大多數。 CTE熱膨脹係數、為13~17ppm/℃。
2、軟板封裝載板
以PI聚醯亞胺、、PE聚酯、樹脂作成的撓性基材的封裝基板,CTE為13~27ppm/℃。
3、陶瓷基板
以氧化鋁、氮化鋁、碳化矽等陶瓷材料作為的封裝基板。 CTE很小,6~8ppm/℃。
以連接的科技區分
1、打線接合載板
金線將IC和載板連接。
2、TAB載板
TAB——TapeAutomatedBonding,卷帶式自動綁定封裝生產。
晶片內引脚與晶片互聯,外引脚與封裝板連接。
3、覆晶接合載板
Filpchip倒貼裝,將晶片正面翻過來Filp、,後以凸塊Bumping、形式直接與載板連接。