集成電路密度和功能的提升推動電子封裝的發展。隨著現代微電子技術的創新,電子設備向著微型化、集成化、高效率和高可靠性等方向發展,電子系統總體的集成度提高,功率密度也同步升高。
電子元件長期在高温環境下運轉會導致其性能惡化,甚至器件被破壞。因此,有效的電子封裝需要不斷提高封裝材料的性能,並將電子線路布線合理化,使得電子元件在不受環境影響的同時,實現良好的散熱,幫助電子系統保持良好的穩定性。
電子封裝一般可按封裝結構、封裝形式和封裝材料組成分類。
從封裝結構來看,主要包括了PCB電路板布線、層間介質和密封材料基板,PCB電路板分為剛性板和柔性板,層間介質分為有機聚合物和無機(氧化矽、氮化矽和玻璃)兩種,起到保護電路、隔離絕緣和防止信號失真等作用。密封材料當前主要為環氧樹脂,占整個電子密封材料的97%以上,環氧樹脂成本低、產量大、工藝簡單。從封裝形式來看,可分為氣密封裝和實體封裝。氣密封裝是指腔體內在管芯周圍有一定氣體空間與外界隔離,實體封裝指管芯周圍與封裝腔體形成整個實體。從材料組成分來看,主要分為金屬基、陶瓷基和塑料基封裝材料。
陶瓷封裝在高致密封裝中具有較大發展潛力。陶瓷封裝屬於氣密性封裝,主要材料有Al2O3、AIN、BeO和莫來石,具有耐濕性好、機械強度高、熱膨脹係數小和熱導率高等優點。金屬封裝的主要材料包括Cu、Al、Mo、W、W/Cu和Mo/Cu合金等,具有較高的機械強度、散熱性能優良等優點。塑料封裝主要使用的材料為熱固性塑料,包括酚醛類、聚酯類、環氧類和有機硅類,具有價格低、質量輕、絕緣性能好等優點。此外,電子封裝還常用四大複合材料,分別為聚合基複合材料(PMC)、金屬基複合材料(MMC)、碳/碳複合材料(CCC)和陶瓷基複合材料(CMC)。
陶瓷封裝中的三個封裝材料
對於集成電路等半導體器件來說,封裝基板需要滿足以下六點要求:
1、高熱導率,器件產生的熱量需要透過封裝材料傳播出去,導熱良好的材料可使晶片免受熱破壞;
2、與晶片材料熱膨脹係數匹配,由於晶片一般直接貼裝於封裝基板上,兩者熱膨脹係數匹配會降低晶片熱應力,提高器件可靠性;
3、耐熱性好,滿足功率器件高溫使用需求,具有良好的熱穩定性;
4、絕緣性好;
5、機械強度高,滿足器件加工、封裝與應用過程的強度要求;
6、價格適宜,适合大規模生產及應用。
六大優勢促使陶瓷封裝成為主流電子封裝。陶瓷基封裝材料作為一種常見的封裝材料,相對於塑膠封裝和金屬封裝的優勢在於:
1、低介電常數,高頻性能好;
2、絕緣性好、可靠性高;
3、強度高,熱穩定性好;
4、熱膨脹係數低,熱導率高;
5、氣密性好,化學性能穩定;
6、耐濕性好,不易產生微裂現象。典型電子封裝材料性能對比
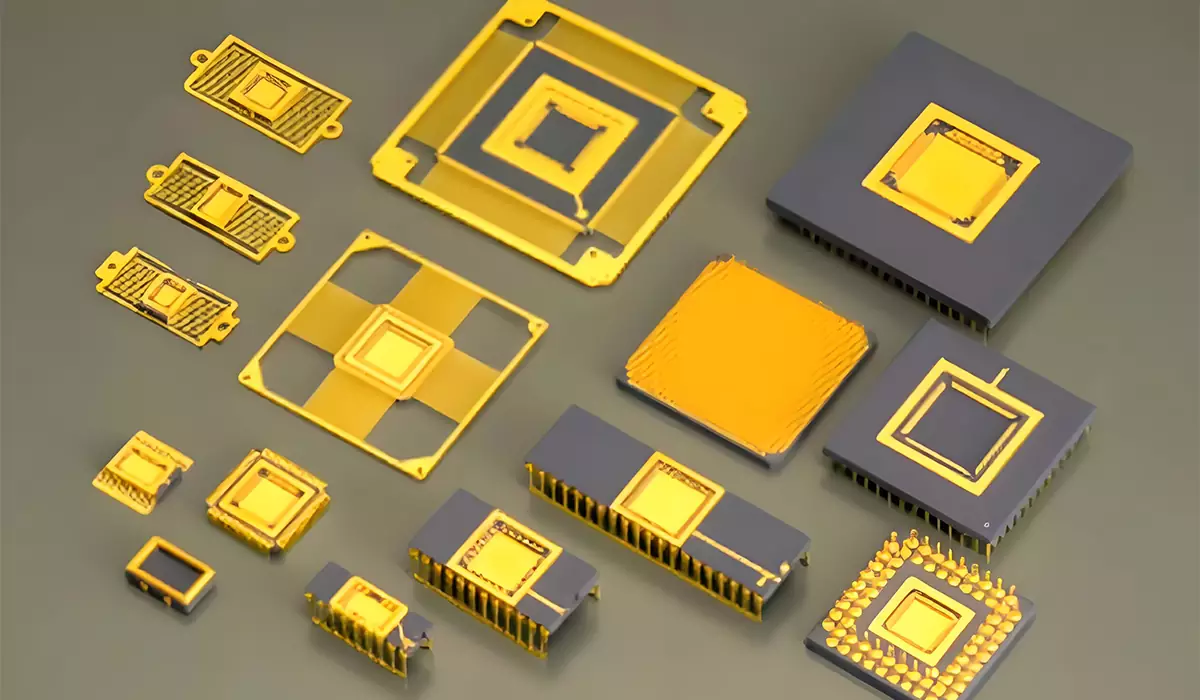
陶瓷封裝
封裝工藝形式多樣,適配各類應用需求。如光模組的封裝就有TOSA和ROSA,主要封裝工藝包括TO同軸封裝、蝶形封裝、COB封裝和BOX封裝。TO同軸封裝多為圓柱形,具有體積小、成本低、工藝簡單的特點,適用於短距離傳輸,但也存在散熱困難等缺點。
蝶形封裝主要為長方體,設計結構複雜,壳體面積大,散熱良好,適用於長距離傳輸。COB即板上芯片封裝,將芯片附在PCB板上,實現小型化、輕型化和低成本等,BOX封裝屬於一種蝶形封裝,用於多通道並行。此外,其餘常見的封裝方式包括雙列直插封裝(DIP)、無引線芯片載體(LCC)等等。
由於陶瓷封裝在高溫、高壓、高頻等極端環境下具有出色的耐受性能和可靠性,因此陶瓷封裝基板在軍工領域應用非常廣泛,可以用於製造雷達系統、無線通訊設備、衛星通訊設備、導彈、航天器、軍用電子設備等軍用產品,以滿足武器裝備對於高性能、高可靠性、抗振動、抗衝擊等特殊要求。