玻璃基板技術應用於晶片開發,以提供更好散熱效能,使晶片在更長時間內保持峰值效能。 同時,玻璃基板的超平整特性使其可以進行更精密的蝕刻,從而使元器件能够更加緊密地排列在一起,提升組織面積內的電路密度。 玻璃基板的應用將為晶片技術帶來革命性的突破,並可能成為未來晶片發展的關鍵方向之一。
什麼是玻璃基板?
晶片基板是用來固定晶圓切好的晶片(Die),封裝的最後一步的主角,基板上固定的晶片越多,整個晶片的電晶體數量就越多。 自上世紀70年代以來,晶片基板材料經歷了兩次反覆運算,最開始是利用引線框架固定晶片,到90年代陶瓷基板取代了引線框架,而現在最常見的是有機材料基板。
有機電路基板本質上是由類似PCB的材料與玻璃編織層壓板層壓而成。有機材料基板加工難度小,還可以高速訊號傳輸,一直被視作是晶片領域的領軍者。 但是有機材料基板也存在一些缺點,就是其與晶片的熱膨脹係數差异過大,在高溫下,晶片和基板之間的連接容易斷開,晶片就被燒壞了。需要通過熱節流仔細控制晶片溫度,代表晶片只能在有限時間維持最高效能,再降回較慢速度,以降低溫度。 囙此,有機電路基板的尺寸受到很大限制,在有限的尺寸下容納更多的電晶體,基板的材料選擇至關重要。
玻璃基板具有卓越的機械、物理和光學特性,能够構建更高效能的多晶片SiP,在晶片上多放置50%的Die。 相比之下,玻璃基板具有獨特的效能,比如超低平面度(極為平整)、更好的熱穩定性和機械穩定性。 由於玻璃材料非常平整,可改善光刻的聚焦深度,同樣面積下,開孔數量要比在有機材料上多得多,玻璃通孔(TGV)之間的間隔能够小於100微米,這直接能讓晶片之間的互連密度提升10倍。 此外,玻璃基板的熱膨脹係數與晶片更為接近,更高的溫度耐受可使變形减少50%,可以降低斷裂的風險,新增晶片的可靠性。 這些優勢使得玻璃基板成為了下一代高密度封裝的理想選擇。
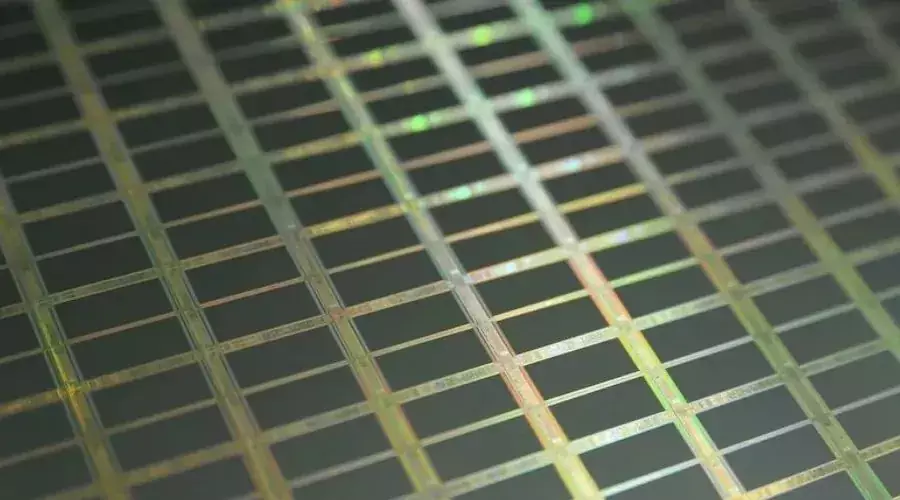
玻璃基板
相較於傳統有機電路基板,玻璃芯基板的厚度可以减少一半左右,玻璃基板不僅功耗更低,而且訊號傳輸速度更快,有望為服務器和材料中心中的大型耗電晶片帶來速度和功耗優勢。 玻璃通孔現在正被成功應用於玻璃基板上,與以往相比,新一代處理器將在更小的體積內實現更多的組件,從而提高了設備的緊湊性和效能。
玻璃基板的易碎性、缺乏與金屬線的黏合力以及通孔填充的均勻性等問題,也為製造過程帶來了不小的挑戰。 選擇適合的玻璃基板材料並確保它與晶片材料的相容性是一個挑戰,這涉及到材料的熱膨脹係數、機械效能、介電特性等方面的匹配。 玻璃基板上的連接技術需要具有高度的可靠性和穩定性,以確保晶片與外部電路的連接質量。 與傳統塑膠封裝相比,玻璃基板封裝的製造成本可能較高,如何確保在大規模生產中保持一致的質量和效能也是需要解决的問題。
玻璃基板的特性非常適合Chiplet,由於小晶片設計對基板的訊號傳送速率、供電能力、設計和穩定性提出了新的要求,在改用玻璃基板後就可以滿足這些要求。
與矽相比,玻璃的高透明度和不同反射係數也為檢測和量測帶來了難度。 許多適用於不透明或半透明材料的量測技術在玻璃上都不太有效,可能導致訊號失真或遺失,影響測量精度。
儘管仍存在諸多挑戰,以及缺乏可靠性數據等,但其無與倫比的平整度和熱效能為下一代緊湊型高性能封裝提供了基礎,讓玻璃基板作為晶片下一代重要技術的潜力不容忽視。 用玻璃材料取代有機基板似乎正在成為業內共識,或者至少是未來一個非常重要的技術路徑。
玻璃基板不僅是材料上的革新,更是一場全球性的技術競賽。 玻璃基板可能成為各國共同完成的新領域,除電路基板製造商外,將吸引全球IT設備製造商和電晶體企業參與。 玻璃基板有望應用在人工智慧、高性能存儲與大模型高性能計算(基於光電子的計算和射頻、矽光集成、高頻寬記憶體)、6G通信領域。