共燒陶瓷板元器件及組件可分為高溫共燒陶瓷(HTCC)和低溫共燒陶瓷(LTCC)兩種。 HTCC是指在1450℃以上與熔點較高的金屬一併燒結的具有電力互連特性的共燒陶瓷板。 隨著通信向高頻高速發展,為了實現低損耗、高速度和高密度封裝的目的,LTCC應運而生,燒結溫度在900℃左右。 然而人類對科學的探究卻從未停止,隨著科技的進步和社會需求的不斷提高,人們又發現了超低溫共燒陶瓷這一新概念。 超低溫共燒陶瓷(ULTCC)是由低溫共燒陶瓷發展而來的一類新型電介質資料。
超低溫共燒陶瓷是一種具有眾多優點的新型多層陶瓷
可在400℃~700℃的極低溫度下燒結,超低燒結溫度使電介質能够與鋁電極及各類電子器件共燒結以實現電子設備的集成化和多功能化,同時還可以降低成本節約能源,適合用於電子元件的集成。 且低燒結溫度允許更廣泛的導體資料用於功能化,使科技混合(電晶體工藝、基於聚合物的微電路製造)成為可能。
低溫共燒陶瓷工藝中最為關鍵的工序之一——燒結
低溫共燒陶瓷基板是在不同層生瓷帶上並行開展打孔、填孔、印刷等工藝,然後將不同層生瓷帶一起疊壓,最後一起燒結形成的立體互聯電路基板。 燒結是LTCC工藝中最為關鍵的工序之一,它直接影響陶瓷的顯微結構,進而影響陶瓷各項性能指標。 燒結過程存在複雜的物理變化和化學變化,升溫速率、峰值溫度和保溫時間是燒結工藝中三個重要的參數,尤其是升溫速率選擇不當,容易造成基板翹曲甚至開裂等問題。 LTCC資料從組成和結構劃分可分為三類,第一類是玻璃陶瓷體系。 第二類是傳統意義上的玻璃陶瓷複合體系。 第三類是玻璃鍵合陶瓷體系。 現時應用較為廣泛的是第一類陶瓷。
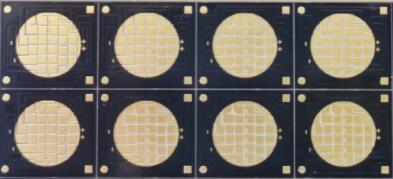
陶瓷基板
介電常數和介電損耗隨升溫速率的變化規律與陶瓷的微觀結構變化有關
升溫速率由4℃/分鐘新增至16℃/分鐘陶瓷內部緻密性逐漸變差,氣孔率逐漸新增。 在升溫速率為4℃/分鐘、8℃/分鐘時燒結的樣品較緻密。 在升溫速率為12℃/分鐘時內部出現明顯氣孔。 升溫速率為16℃/分鐘時,樣品斷面氣孔進一步新增。 這是因為在排膠完成後,由於升溫速率較慢,玻璃陶瓷材料隨著溫度的升高,晶粒可有序地生長,隨著晶相的新增和晶粒的長大,內部的氣孔可慢慢地排出,實現玻璃陶瓷材料的緻密化。 當升溫速率過快時內部的晶相未能充分地析晶、長大內部的氣孔不能及時排出,導致內部氣孔增多。 根據複合材料介電常數混合定律,低介電常數物質的引入會降低複合材料的介電常數。 由於空氣的介電常數為1,低於CaSiO3、CaB2O4等晶相的介電常數,囙此隨著升溫速率新增,介電常數變小,介電損耗變大。
不同升溫速率會影響基板翹曲度
當升溫速率為4℃/分鐘~8℃/分鐘時,基板翹曲度為0.21%左右,隨著升溫速率升溫至12℃/分鐘~16℃/分鐘基板翹曲度也在逐漸新增,在16℃/分鐘時,翹曲度為0.82%左右。
由此看出升溫速率8℃/分鐘時平整性較好,16℃/分鐘時中間凸起明顯。 這主要是因為玻璃陶瓷材料與銀電子漿料共同升溫燒結,當升溫速率為4℃/分鐘~8℃/分鐘時,銀電子漿料的燒結收縮速率與玻璃陶瓷的燒結收縮速率較為接近,但是當升溫速率新增至12℃/分鐘~16℃/分鐘時,由於銀電子漿料的燒結收縮速率遠大於玻璃陶瓷材料的燒結收縮速率, 囙此出現了燒結嚴重不匹配的現象,從而導致了基板拱起的現象。
不同升溫速率會影響膜層附著力
隨著升溫速率的新增,焊盤膜層附著力呈降低的趨勢。 這是因為升溫速率為4℃/分鐘~8℃/分鐘時,陶瓷燒結產生的液相較多,可以與金屬膜層形成較好的附著力,同時瓷體較緻密,氣孔較少,金屬膜層與陶瓷間的氣孔少,囙此結合力較高,但是當昇溫速率新增至12℃/分鐘~16℃/分鐘時,由於陶瓷燒結產生的液相含量降低,金屬膜層與陶瓷間的氣孔較多, 降低了金屬膜層與陶瓷的結合力。 隨著升溫速率的新增金屬漿料與陶瓷的共燒匹配性會變差,這也可能會導致金屬膜層與陶瓷間結合力的降低。
LTCC液相燒結
LTCC資料一般都是玻璃陶瓷或玻璃複合陶瓷粉的結構,具有較多的玻璃成分,囙此LTCC燒結屬液相燒結。 當LTCC資料在高溫段(≥500℃)時,玻璃相軟化成黏性液體,將陶瓷粉粒拉近、緊貼,並使粉粒活化,在濃度差和介面張力的推動下,促使基板中氣孔長大和玻璃流動,實現陶瓷體積收縮和基板緻密化。 單層LTCC生瓷帶通過流延成型,而多層生瓷帶通過等靜壓成型形成緻密的坯體。 LTCC基板經過450℃的排膠峰值溫度後,坯體經排膠發泡後較為疏鬆,其顆粒間大部分呈分開狀態,顆粒間的空隙很多。 隨著燒結溫度的升高和時間的延長,特別是650℃後陶瓷粉體的DSC曲線可以看出,陶瓷粉體開始吸熱軟化,其玻璃化溫度為668℃,這期間陶瓷顆粒間不斷發生接觸和重排,大氣孔逐漸消失,物質間傳質過程逐漸開始進行,顆粒間接觸狀態由點接觸逐漸擴大為面接觸,固-固接觸面積新增, 固-氣表面積相應减少。
結論
(1)燒結升溫速率顯著影響了LTCC基板的微觀結構。 隨著燒結升溫速率的提高,製備的陶瓷基板內部氣孔增多,導致基板介電常數顯著降低,介電損耗增大,膜層附著力和抗衝擊能力變差。 當燒結升溫速率在8℃/分鐘時,製備的LTCC基板不僅氣孔率低,强度高,而且具有良好的介電效能和熱力學效能。
(2)燒結升溫速率會顯著影響銀電子漿料與玻璃陶瓷燒結收縮的匹配性。 當燒結升溫速率從4℃/分鐘升高到16℃/分鐘時,翹曲度從0.21%提高到0.82%,導致陶瓷基板翹曲,銀電子漿料的燒結收縮速率與玻璃陶瓷的燒結收縮速率失配。
(3)LTCC陶瓷基板的燒結需要適當的升溫速率。 升溫速率會影響燒結過程的傳質、晶相長大,以及氣孔排出和緻密化過程,囙此會影響力學和電學效能。