三維陶瓷電路板的應該非常廣泛,許多微電子器件(如加速度計、陀螺儀、深紫外LED等)晶片對空氣、濕氣、灰塵等非常敏感。 如LED晶片理論上可工作10萬小時以上,但水汽侵蝕會大大縮短其壽命。 為了提高這些微電子器件效能,必須將其晶片封裝在真空或保護氣體中,實現氣密封裝。 囙此,必須首先製造含腔體(圍壩)結構的三維陶瓷電路板,滿足封裝應用需求。
常見的三維陶瓷電路板主要有:高/低溫共燒陶瓷電路板(HTCC/LTCC)、多層燒結三維陶瓷電路板(MSC)、直接粘接三維陶瓷電路板(DAC)、多層鍍銅三維陶瓷電路板(MPC)以及直接成型三維陶瓷電路板(DMC)等。
HTCC基板製造過程中先將陶瓷粉(Al2O3或AlN)加入有機黏結劑,混合均勻後成為膏狀陶瓷漿料,接著利用刮刀將陶瓷漿料刮成片狀,再通過乾燥工藝使片狀漿料形成生胚。 然後根據線路層設計鑽導通孔,採用絲網印刷金屬漿料進行佈線和填孔,最後將各生胚層疊加,置於高溫爐(1600℃)中燒結而成。 由於HTCC基板製造工藝溫度高,囙此導電金屬選擇受限,只能採用熔點高但導電性較差的金屬(如W、Mo及Mn等),製作成本較高。
此外,受到絲網印刷工藝限制,HTCC基板線路精度較差,難以滿足高精度封裝需求。 但HTCC基板具有較高機械強度和熱導率[20W/(m·K)~200W/(m·K)],物化性能穩定,適合大功率及高溫環境下器件封裝。
為了降低HTCC製造工藝溫度,同時提高線路層導電性,業界開發了LTCC基板。 與HTCC製造工藝類似,只是LTCC製造在陶瓷漿料中加入了一定量玻璃粉來降低燒結溫度,同時使用導電性良好的Cu、Ag和Au等製造金屬漿料。 LTCC基板製造溫度低,但生產效率高,可適應高溫、高濕及大電流應用要求,在軍工及航太電子器件中得到廣泛應用。
雖然LTCC基板具有上述優勢,但由於在陶瓷漿料中添加了玻璃粉,導致基板熱導率偏低[一般僅為3W/(m·K)~7W/(m·K)]。 此外,與HTCC一樣,由於LTCC基板採用絲網印刷科技製作金屬線路,有可能因張網問題造成對位誤差,導致金屬線路層精度低。 而且多層陶瓷生胚疊壓燒結時還存在收縮比例差异問題,影響成品率,一定程度上制約了LTCC基板科技發展。
與HTCC/LTCC基板一次成型製造三維陶瓷電路板不同,臺灣陽升公司採用多次燒結法製造了MSC基板。 首先製造厚膜印刷陶瓷電路板(TPC),隨後通過多次絲網印刷將陶瓷漿料印刷於平面TPC基板上,形成腔體結構,再經高溫燒結得到MSC基板。
由於陶瓷漿料燒結溫度一般在800℃左右,囙此要求下部的TPC基板線路層必須能耐受如此高溫,防止在燒結過程中出現脫層或氧化等缺陷。 TPC基板線路層由金屬漿料高溫燒結(一般溫度為850℃~900℃)製造,具有較好的耐高溫效能,適合後續採用燒結法製造陶瓷腔體。
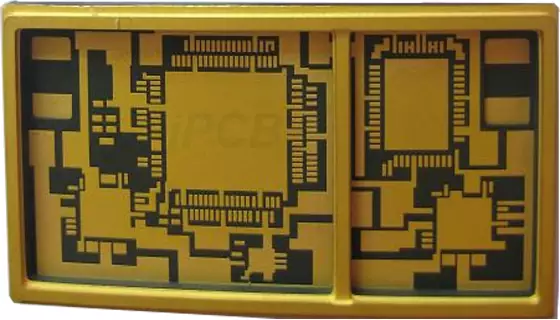
三維陶瓷電路板
MSC基板科技生產設備和工藝簡單,平面基板與腔體結構獨立燒結成型,且由於腔體結構與平面基板均為無機陶瓷材料,熱膨脹係數匹配,製造過程中不會出現脫層、翹曲等現象。 其缺點在於,下部TPC基板線路層與上部腔體結構均採用絲網印刷佈線,圖形精度較低。 同時,因受絲網印刷工藝限制,所製造的MSC基板腔體厚度有限。 囙此MSC三維基板僅適用於體積較小、精度要求不高的電子器件封裝。
HTCC、LTCC及MSC基板線路層都採用絲網印刷製造,精度較低,難以滿足高精度、高集成度封裝要求,囙此業界提出在高精度DPC陶瓷電路板上成型腔體製造三維陶瓷電路板。 由於DPC基板金屬線路層在高溫(超過300℃)下會出現氧化、起泡甚至脫層等現象,囙此基於DPC科技的三維陶瓷電路板製造必須在低溫下進行。
MPC基板採用圖形電鍍工藝製造線路層,避免了HTCC/LTCC與TPC基板線路粗糙問題,滿足高精度封裝要求。 陶瓷電路板與金屬圍壩一體化成型為密封腔體,結構緊湊,無中間粘結層,氣密性高。
MPC基板整體為全無機資料,具有良好的耐熱性,抗腐蝕、抗輻射等。 金屬圍壩結構形狀可以任意設計,圍壩頂部可製造出定位臺階,便於放置玻璃透鏡或蓋板,現時已成功應用於深紫外LED封裝和VCSEL雷射器封裝,已部分取代LTCC基板。
其缺點在於:由於幹膜厚度限制,製造過程需要反復進行光刻、顯影、圖形電鍍與表面研磨,耗時長(厚度為600μm圍壩需要電鍍10h以上),生產成本高。 此外,由於電鍍圍壩銅層較厚,內部應力大,MPC基板容易翹曲變形,影響後續的晶片封裝質量與效率。
DMC基板的製造,首先製造平面DPC陶瓷電路板,同時製造帶孔橡膠模具。 將橡膠模具與DPC陶瓷電路板對準合模後,向模具腔內填充犧牲模資料。 待犧牲模資料固化後,取下橡膠模具,犧牲模粘接於DPC陶瓷電路板上,並精確複製橡膠模具孔結構特徵,作為鋁矽酸鹽漿料成型模具。 隨後將鋁矽酸鹽漿料塗覆於DPC陶瓷電路板上並刮平,加熱固化,最後將犧牲模資料腐蝕,得到含鋁矽酸鹽免燒陶瓷圍壩的三維陶瓷電路板。
鋁矽酸鹽漿料固化溫度低,對DPC陶瓷電路板線路層影響極小,並與DPC基板製造工藝相容。 橡膠具有易加工、易脫模以及價格低廉等特點,能精確複製圍壩結構(腔體)形狀與尺寸,保證圍壩加工精度。 有實驗結果表明,腔體深度、直徑加工誤差均小於30μm,說明該工藝製造的三維陶瓷電路板精度高,重複性好,適合量產。 鋁矽酸鹽漿料加熱後脫水縮合,主要產物為無機聚合物,其耐熱性好,熱膨脹係數與陶瓷電路板匹配,具有良好的熱穩定性。 固化體與陶瓷、金屬粘接强度高,製造的三維陶瓷電路板可靠性高。 圍壩厚度(腔體高度)取決於模具厚度,理論上不受限制,可滿足不同結構和尺寸的電子器件封裝要求。