一、LTCC基板電路概述
低溫共燒陶瓷(LTCC) 技術是集互聯、無元件和封裝於一體的多層陶瓷製造技術。隨著科技的不斷進步,現在的電子產品的外觀可以變得更小更薄,但功能更強大。以手機的無線通訊行業為例,手機的尺寸縮小,早期的行動電話的功能是從最簡單的音訊廣播資料開始,現在已經發展成掌上網路電腦。如果可以將部分無源元件集成到基板中,則不僅有利於系統的小型化,增加電路的組裝密度,還有利於提高系統的可靠性。目前的集成封裝技術主要包括薄膜技術、矽片半導體技術、多層電路板技術和LTCC技術。 LTCC技術是一種低成本封裝的解決方案,具有研製週期短的特點。低溫共燒陶瓷技術可以滿足後者輕、薄、短、小的需求。但是低溫共燒陶瓷基板具有高硬度、易碎的特性。因此,切割機切割硬基材時,基材與切割刀片之間會產生較大的摩擦力,摩擦產生的應力會傳遞到切割刀片上。
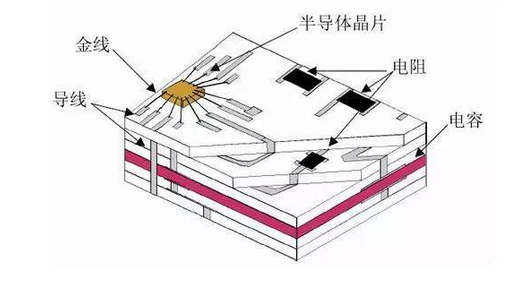
2、LTCC基板加工技術
圖2為LTCC基板製造工藝流程圖,主要包括混料、流延、打孔、填孔、絲網印刷、層壓、等靜壓、排膠燒結等,下面簡要介紹各工藝的主要工序。
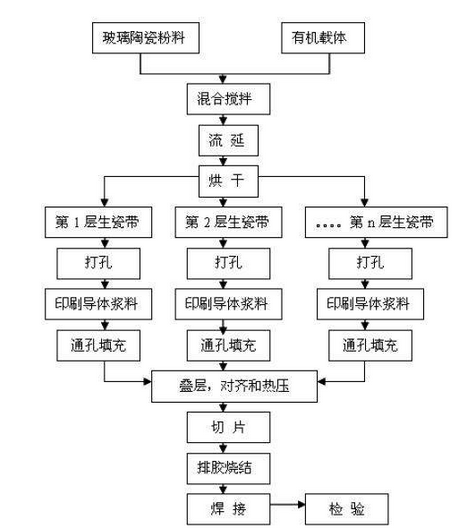
混料和流延:將有機物(主要由聚合物粘合劑和溶解於溶液的增塑劑組成)和無機物(由陶瓷和玻璃組成)按一定比例混合,採用球磨法研磨均質,然後澆注在一個移動的載帶上(通常為聚酯薄膜),通過一個乾燥區,除去所有溶劑,通過控制刀片間隙,流延成所需厚度。此工藝的一般厚度公差為±6%。
沖孔:採用機械沖孔、鑽孔或鐳射鑽孔技術形成通孔。通孔是在生瓷片上沖出的小孔(通常直徑為0.1-0.2mm),用於不同層間互連電路。在這個階段還要沖模孔,以幫助疊片時對準;對準孔用於印刷導體和介質時自動對位。
印刷:使用標準厚膜印刷技術對導體漿料進行印刷和烘乾。通孔填充和導體圖形在箱式或鏈式爐中根據相關工藝溫度和時間干進行烘乾。根據需要,所有電阻器、電容器和電感器都在此階段進行印刷和烘乾。
通孔填充:採用傳統的厚膜絲網印刷或範本擠壓把特製的高固體顆粒含量的導體漿填充通孔。
排膠和燒結:200-500°C之間的區域稱為有機排膠區(建議在該區域疊層保溫至少60分鐘)。然後在 5-15 分鐘將疊層共燒至峰值溫度(通常為 850°C)。燒成金屬化的典型排膠和燒成曲線需要的2-10h。燒成的部件準備好後進行燒制工藝,例如在頂面上印刷導體和精密電阻器,然後在空氣中燒成。如果 Cu用於金屬化,則必須在 N2 鏈式爐中進行燒結。
檢驗:然後對線路進行鐳射調阻(如果需要)、測試、切片和檢驗、LTCC 封裝中可用釺焊引線或散熱片(如果需要)。
3、LTCC基板電路加工案例
3.1 LTCC基板微通孔形成技術
微通孔的形成是低溫共燒陶瓷多層基板高密度互連中極為關鍵的工藝,因為孔徑大小和位置精度都將直接影響佈線密度和基板品質。為了實現超高密度,通孔孔徑應小於100μm。 LTCC生瓷帶的微孔製作方法有:機械沖孔和鐳射打孔。
3.1.1 機械沖孔
用數控衝床沖孔是對生瓷帶沖孔的較好方法,尤其是定型產品,沖孔更有優勢。用衝床模具一次可沖出上千個孔,最小直徑可達50μm。沖孔速度快,精度高,適合大批量生產。在生陶瓷帶上製作微通孔時,需要一個與微通孔尺寸相同的沖頭和一個模具。模具的開口一般比沖頭模直徑大12.5μm。
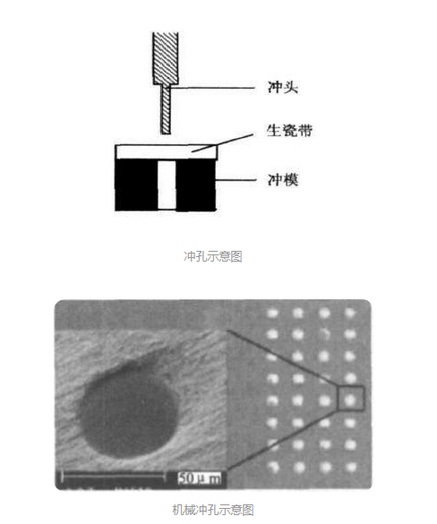
製作微通孔的關鍵技術點是:安裝和操作微小沖頭。當沖頭的直徑小於100μm後,由於堅固度的降低,沖頭的安裝和操作會越來越困難。大多數衝壓缺陷不是在衝壓過程中形成的,而是由於操作不當造成的。因此需要專用工具來安裝微型沖頭,並且在安裝和操作過程中必須避免沖頭的撞擊和損壞。對準沖頭和沖模。要使機械沖孔生產出高品質的通孔,很大程度上取決於沖頭和模具之間的對準度。如果兩個裝置沒有對準,通孔品質會下降,沖模會受損,沖頭也可能會斷裂。確保微通孔製作品質,微通孔的品質包括微通孔的形狀、尺寸和內部貫穿狀況。
機械沖孔形成的微通孔的直徑和間距較好。頂部邊緣比較平滑,但底部邊緣比較粗糙,內壁比較平直。頂部和底部開口大小相連近。不同厚度的LTCC陶瓷帶所生產的微通孔尺寸也是一致的,即陶瓷帶的厚度與通孔尺寸的比率不會影響通孔的品質。使用機械沖孔的方法,在厚度為50-254 μm的不同LTCC瓷帶上形成的50、75和100 μm的微通孔表明,不同尺寸的微通孔在LTCC瓷帶正面和背面的開口直徑大小都在允許的測量誤差範圍內,但在陶瓷帶背面的通孔開口偏差更大。顯微鏡下檢查沖孔後模開口的變化,比原來的開口尺寸有所增加,這是沖模開口磨損造成的。不同微通孔的分析資料表明,沖頭的尺寸決定了通孔正面開口的大小,而背面通孔的直徑則受沖模開口大小的影響。
因此,當沖模開口因磨損超過一定值時,微過孔背面的開口會大大增加,此時應更換沖模。另一個影響微過孔品質的因素是過孔中的殘留物,它是殘留在通孔開口處的一小片LTCC陶瓷帶,在沖孔時沒有完全去除。這些殘留物主要在LTCC生瓷帶層的背面,與通孔邊緣相連,一般為10-25μm。含有殘留物的通孔數量隨著通孔尺寸的增大而減少,殘留物的含量與陶瓷帶的厚度無關。
3.2微孔注入法
通常微孔注入法效果最好,但需要專門的設備。在微孔注射系統中,影響通孔填充品質的主要因素包括注入壓力、注入時間、填充漿料粘度以及LTCC陶瓷帶與通孔填充掩模之間的對準情況。一旦確定了適用於整個製造工藝的參數,就可以在幾秒鐘內在 LTCC 生瓷帶層中填充數千個通孔。注意微孔金屬化的未填充、過填充和少填充。
填充了銀漿的 75μm 微通孔。填滿漿料的通孔具有所需的尺寸和滿意的填充品質。 LTCC 瓷帶背面過度填充的缺陷,這是由於在真空卡盤和 LTCC 瓷帶之間使用了不合適的多孔襯紙造成的。當填充通孔時,掩模版與LTCC陶瓷帶之間存在未對準狀況時,與掩模版接觸的LTCC生瓷帶通孔的正面會出現過填充缺陷。間距為 75μm 的頂部通孔。由於過度填充而使孔距被縮短。如果通孔之間發生過填,則必須增加孔間距,以避免過填充的額外漿料導致短路,但這會降低內部互連密度。
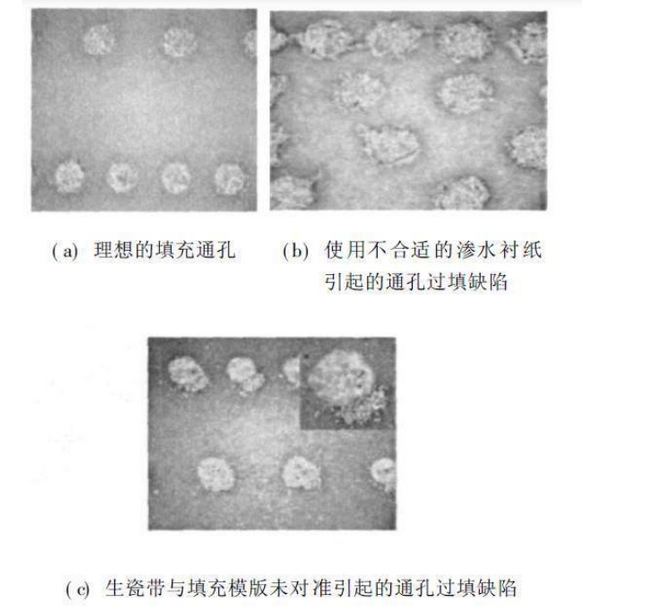
3.3 LTCC基材排膠和燒結
燒結的技術要點是控制燒結收縮率和基材的整體變化,控制兩種材料的燒結收縮性能,避免產生微觀和宏觀缺陷,以及實現導體材料的抗氧化作用和在除燒結過程中去除粘合劑。普通LTCC基板的燒結收縮率主要是通過控制粉體的粒徑、流延粘結劑的配比、熱壓疊片的壓力、燒結曲線等手段來實現的。但是一般LTCC共燒體系沿X-Y方向的收縮仍然在12-16%。借助無壓燒結或壓力輔助燒結等技術,可以獲得X-Y方向零收縮的材料。
實現零收縮的工藝有: 自約束燒結,基材在自由共燒過程中表現出自身抑制平面方向收縮的特性,這種方法不需要增加新設備,但材料體系獨特,不能滿足製造不同性能產品的要求。壓力輔助燒結,通過在Z軸方向加壓燒結來抑制X-Y平面上的收縮;無壓力輔助燒結,在層壓材料之間加入夾層(如在LTCC燒結溫度下不燒結的氧化鋁),以限制X和Y軸方向的移動,燒成後研磨掉上下面夾持用的氧化鋁層;複合板共同壓燒法,將生坯體粘附在金屬板(如高機械強度的鉬或鎢等)進行燒結,利用金屬片的束縛作用降低生坯體在X-Y方向的收縮。陶瓷薄板和生坯片疊層共同燒結法,陶瓷薄板作為基板的一部分,燒成後不必去除,也不存在抑制殘留的隱憂。
3.4 LTCC電路板大面積接地釺焊
LTCC電路基板大面積接地釺焊工藝設計,提高LTCC電路基板大面積接地釺焊的釺著率和可靠性的釺焊工藝。在LTCC電路基板接地面設置 (Ni+M)複合金屬膜層,根據試驗測試對比,其耐焊性(>600s)明顯優於常規金屬化接地層(常規要求>50s);在LTCC電路基板的接地面一端預置一個“凸點”,通過X射線掃描圖的對比分析,增加“凸點”的設計提高了大面積接地釺焊的釺著率。研究表明:新的釺焊工藝設計保證了LTCC電路基板大面積接地的釺焊可靠性和一致性。
3.4.1 試驗材料和設備
LTCC電路板:採用Ferro A6-S生陶瓷燒結而成的多層電路板,尺寸80mm x 30mm x 1.2mm,元件殼體材料為Kovar合金,盒體壁厚1.0mm,底部尺寸80mm x 30mm,底部厚度為2.0mm,焊料為0.1mm厚的Sn63Pb37焊片。
測試設備:自製的充氮氣手套箱,內有加熱台,加熱台的額定工作溫度為450℃。
X射線檢測設備:MACROSCIENCE MXR-160。
數碼相機設備:OLYMPUS MODEL NO. C5060。
3.4.2 LTCC電路板表面金屬化方法
LTCC電路基板表面金屬化的方法目前大致有兩種:厚膜燒結法和濺射薄膜電鍍增厚法。濺射薄膜再電鍍增厚法雖然在單層陶瓷基板的薄膜電路加工中得到了廣泛的應用。但是在LTCC電路板仍處於探索階段。目前提高LTCC電路板耐焊性的一般方法是燒結一層鈀銀。
3.4.3 耐焊性測試方法
選擇三種試樣進行耐焊性測試對比:(1)厚膜鈀銀層(約12μm)試樣; (2) 厚膜金層(約37μm)試樣; (3) 設置含Ni Barrier layer 3(Nj+M)複合金屬膜(約10μm)樣品,M為金屬代號。
參考GJB548A-96(微電子器件試驗方法和程式):將基板垂直浸入(215±5)℃熔融焊料的錫槽中,每次58,共10次(焊料成分為63Sn37Pb的共晶焊料,焊劑為25%的松香酒精溶液)清洗、塗焊劑,被檢圖形應無翹曲、脫落、斷裂、被熔蝕不超過20%的面積。以上3種試樣均能通過耐焊性的試驗檢測標準,且未見被熔蝕的地方,隨後將上述3種試樣(新的試樣)金屬化層表面上放置塗有焊劑的焊片,在氮氣保護下,在240℃(設定值)的熱臺上加熱保持,觀察焊料相應試樣金屬化層表面的熔蝕情況。
3.4.4 LTCC電路板與盒體的氣保焊方法
可實現LTCC電路基板與箱體底部大面積釺焊的方法有:氣體保護釺焊、真空釺焊、空氣中熱板釺焊。在空氣中相應的軟釺焊料呈液態時更容易與空氣中的氧氣發生化學反應,因此氣體保護釺焊與空氣中熱板釺焊相比具有明顯的優勢。但是,氣體保護釺焊和真空釺焊兩種方法各有優缺點。真空中熱量的傳導主要靠輻射,遮蔽效應較明顯。由於微波元件尺寸較小,每個工件上的溫度不均勻,導致部分工件溫度高,焊錫過度流動,部分工件溫度不足。未完全熔化和鋪展,釺焊品質一致性差,加熱週期長,效率低。
氣體保護釺焊熱傳導的三種方式並存,操作方便,效率高,然而由於氣體的存在釺著率受到限制。在一般條件下可達75%以上,呈隨機分佈。對於微波電路來說,帶來了很大的不確定性。為了提高釺焊率,採用了預先設置“凸點”的方法。凸點的材料與大面積釺焊的焊片材料相同。凸點的製作方法,在對應位置放置適量的錫膏,通過熱風回流成凸點。凸點的大小隨基板的長度而作相應變化。凸點製作完成後,在盒體底部預先設置與已清除氧化皮且與凸點成分相同的焊片。在有氣體保護下的熱板上加熱來實現LTCC與盒體底部的大面積接地焊。
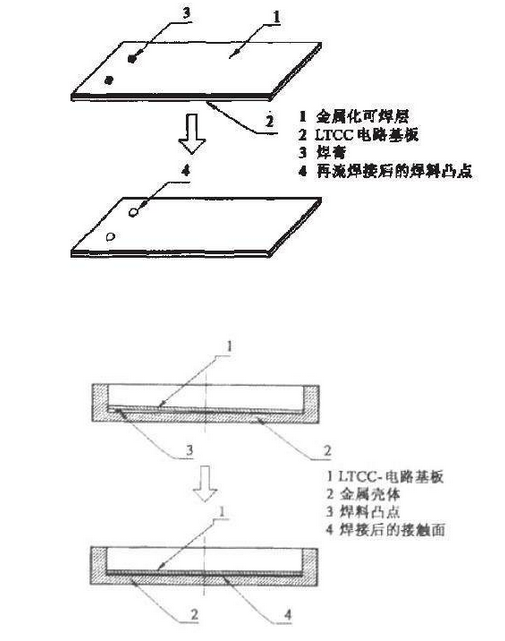
3.4.5 釺焊率檢測
大面積釺焊後,理論上焊料利用毛細現象的原理,會盡可能地填充LTCC與箱體底部之間的空隙。但是由於保護氣氛的存在,熔化的焊料會隨機形成多個包圍圈,將氣體包裹在裡面。釺焊介面內部有空腔或凝固過程中焊料合金鬆動,則X射線很容易通過,從而在成像圖像中產生白色或灰白色的亮點,未設置“凸點”焊接工藝的X射線掃描圖,箭頭表示明顯的焊接缺陷,釺著率在75%左右,設置“凸點”焊接工藝的X射線掃描圖,箭頭所指為輕微焊接缺陷,釺焊率為98%以上。由於“凸點”的存在,加熱過程中人為造成LTCC基板兩端的溫度存在差異。隨著“凸點”的緩緩坍塌,有利於盒體底部焊料與LTCC基板之間夾雜氣體排除。 X射線檢測圖片證明在氣體保護下,在基體的焊接面上設計“凸點”可以提高釺焊率。
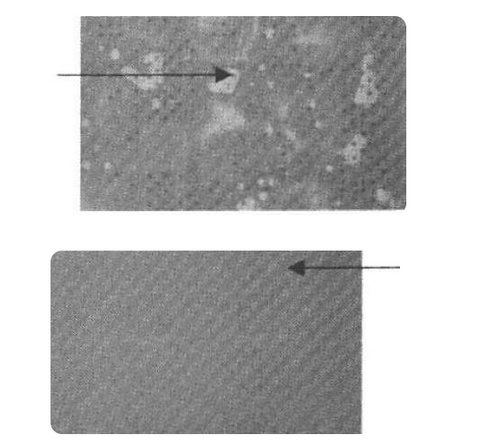
3.4.6 LTCC電路板大面積接地釺焊結論
(1)設置(Ni+M)複合金屬膜層,大大提高了LTCC基板大面積金屬化層對Sn63Pb37焊料的耐焊性,保證了LTCC基板與盒體的可靠釺焊;
(2)採用氣體保護,在LTCC基板的焊接面上設計“凸點”在提高LTCC電路基板與盒體之間的釺焊率非常有效。
3.5 LTCC 電路檢測
對排脂、燒結、焊接後的LTCC元件必須進行多方面的檢測,以確保其性能的可靠性。 這些檢測包括外觀、尺寸、強度、電氣性能等方面。